-
メール
frank.yang@acuitik.com
-
電話番号
13817395811
-
アドレス
上海市浦東新区祥科路298号4階
製品カテゴリー
蘇州知識科学技術有限公司
概要
NS-30半導体薄膜非接触厚さ測定器は白色光干渉原理に基づく高精度測定装置であり、自動測定と正確な厚さ分布分析が必要なシーンに特に適している。
製品詳細
NS-30半導体薄膜非接触厚さ測定器は白色光干渉原理に基づく高精度測定装置であり、自動測定と正確な厚さ分布分析が必要なシーンに特に適している。
1、核心原理
垂直入射した高安定広帯域光がサンプル表面に入射し、各フィルム層間に光学干渉現象が発生し、反射光はスペクトル分析及び回帰アルゴリズムを経てフィルム各層の厚さを算出することができる。ナノスケール〜ミクロンスケールの透明または半透明フィルム層の厚さ、反射率、屈折率などのパラメータの測定に適している。
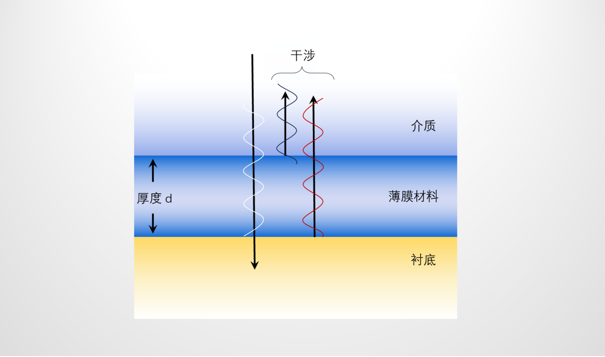
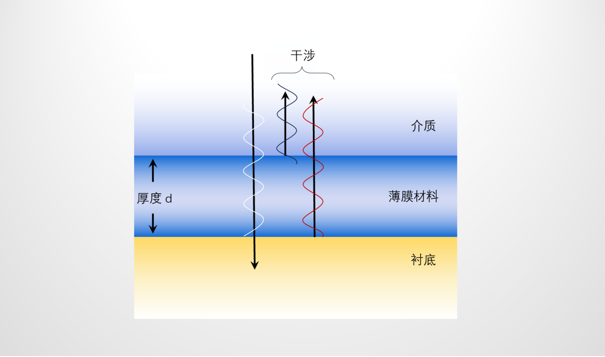
2、具体的なパラメータ
−コア原理:垂直入射広帯域白色光干渉技術
-測定範囲:1 nmから250μm
-波長範囲(NIPモデル):950 nm-1700 nm(近赤外帯)
-精度:3 nmまたは0.4%
-繰り返し精度:0.1 nm
-測定速度:<1秒/単点
-スポットサイズ:1.5 mm
-コアの特徴:自動サンプルステージ、事前にポイントを設定して自動測定を行い、そして厚さ、屈折率、反射率の2 D/3 D分布図を生成することができる
-サンプルテーブルサイズ:100 mm~450 mmオプション
−測定能力:多層複合フィルムの各層の厚さ、屈折率(n)及び反射率を測定可能
3、コア機能


4、実測結果の展示